FIB後処理用ナノミル装置
Model 1040 NanoMill
超低エネルギーの濃縮イオンビームを使用して、
透過電子顕微鏡(TEM)観察に最適な最高品質の試料を生成
FIB(集束イオンビーム)により作製されたTEM試料に対する、後処理用ミリング装置です。
特長
●超低エネルギー不活性ガスイオン源
●走査能力を備えた濃縮イオンビーム
●ダメージ層を再蒸着せずに除去
●収束イオンビーム(FIB)加工後の処理に最適
●従来の方法で作成された試料から得られる結果が向上
●室温から極低温のナノミリング
●高処理能力用途に適した高速試料交換
●コンピュータ制御され、すべてをプログラム設定できる、操作性に優れた装置
●汚染のない乾式真空システム
FIBを用いて試料を作製すると、表層のアモルファス化やガリウムの注入を生じることが多くあり、このようなダメージ層は10nm~30nmになることもあります。NanoMillは、このようなダメージ層の除去に最適な装置です。SED(2次電子検出器)により試料の画像を取得し、目的のスポットのみをピンポイントでイオンミリング出来ますので、リデポ(再堆積)の発生も防げます。
●TEM観察に最適な試料作製
Model 1040 NanoMill は、高度なTEMイメージングや解析に必要とされる超薄で高品質の試料を作成する優れた装置です。
可変エネルギーのイオン源が、わずか50eVという低イオンエネルギーを生成します。
さらに、ビームサイズもわずか4ミクロンと小さいため、対象となる領域のアモルファス化や注入、再蒸着が不要になります。
最適な用途は、集束イオンビーム(FIB)加工後の処理です。
●対象となる超低エネルギーのナノミリング
Model 1040 NanoMillのイオン源は、フィラメントを使用したイオン化チャンバーと 静電レンズを特長としています。このイオン源は、超低イオンエネルギーと 小さなビーム直径を生成するために特別に開発されたものであり、 不活性ガス(主にアルゴン)を使用し、可変作動距離にて50eVから4kVの使用電圧範囲を 備えています。このイオン源は、適切な時間内に試料のダメージを除去することができる 十分な電流密度を生じるため、ミリング時間はわずか20分で行うことができます。
イオンビームは直径4ミクロンのスポットに集束させることができるため、 スパッタリングされた材料の対象領域への再蒸着が最小限に低減されます。 ビーム電流とスポットサイズは、異なるサイズのTEM用アパーチャーを使用して 調整されます。イオン源のフィードバック制御アルゴリズムは、 幅広いナノミリングパラメータにより、安定し再現可能なイオンビーム条件を 自動的に生成します。
●SED試料のターゲット設定
操作中に試料に対するイオンビームの位置を把握することは極めて重要です。 これは、サポートグリッドに乗せるFIB薄層がわずか10平方ミクロンとなることもある、 FIB加工後の処理で特に重要となります。
ターゲット設定によりビームが特定の対象領域に照射されます。
そして、この試料の対象領域から生成されるイオン誘発二次電子を、 ET(Everhart-Thornley)二次電子検出器(SED)で結像します。このSED出力はモデル1040ナノミルのイメージング電子機器で処理され、 暗黙的にイオンビームと位置合わせされた試料をリアルタイムに表示します。 走査速度は様々に選択することが可能で、イメージングをより高速化させたり、 画質を向上させることができます。フレームの平均化はノイズの削減に使用されます。
●コンピュータ制御
すべてプログラム可能なModel 1040 NanoMill は、最小限のユーザーの介入で 動作します。イオン源パラメータ、ミリング角度、試料位置、温度閾値、 加工時間といったナノミリング条件を、単一画面の使いやすい グラフィカルインターフェースでプログラムできます。
●シリコン(Si)の透過電子顕微鏡(TEM)画像
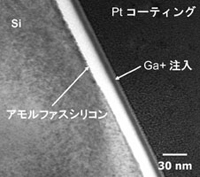
Ga注入層とアモルファス層を示す、FIB加工後のシリコン断面の明視野TEM画像

Gaの注入と表面のアモルファス化が位相差画像法に及ぼす影響を示した、向き[110]でのシリコンの平面図高分解能TEM画像

Gaの注入と表面のアモルファス化が位相差画像法に及ぼす影響を示した、向き[110]でのシリコンの平面図高分解能TEM画像
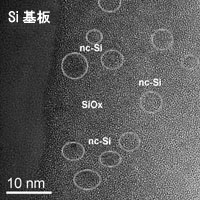
アモルファスSiOx基材に埋め込まれたシリコン量子ドット。サイズとビーム感度により、これらの量子ドットは調製されたままのFIB板晶では見えなかった。
資料提供:RWTHアーヘン大学およびエルンストルシュカセンター(ユーリヒ研究センター)J. Mayer, A. Dimyati
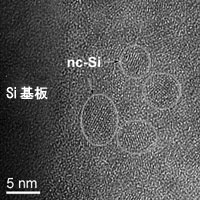
アモルファスSiOx基材に埋め込まれたシリコン量子ドット。サイズとビーム感度により、これらの量子ドットは調製されたままのFIB板晶では見えなかった。
資料提供:RWTHアーヘン大学およびエルンストルシュカセンター(ユーリヒ研究センター)J. Mayer, A. Dimyati

Ga注入層とアモルファス層の除去後に 明確に分解されたシリコン原子構造(ダン ベル)を示す、収差補正済みの高分解能TEM画像
画像提供:オックスフォード大学Angus Kirkland教授およびCrispin Hetherington博士
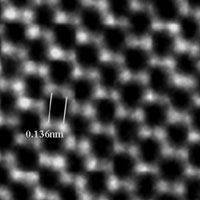
シリコンダンベル画像の拡大部分(左)
画像提供:オックスフォード大学Angus Kirkland教授およびCrispin Hetherington博士

Ga注入層とアモルファス層の除去後に伝達された高位の試料周期性を示す、上図に示したシリコン格子画像のFFT(左)
画像提供:オックスフォード大学Angus Kirkland教授およびCrispin Hetherington博士

Gaの注入と表面のアモルファス化が位相差画像法に及ぼす影響を示した、向き[110]でのシリコンの平面図高分解能TEM画像画像寸法:800 nm×800 nm

Ga注入層とアモルファス層が低エネルギー(200eV)のナノミルにより除去された後の、向き[110]でのシリコンの平面図高分解能TEM画像。損傷が除去/改善された大きく薄い領域が考えられる。
●プラズマクリーニング
酸素25%とアルゴン75%から成るプロセスガスから誘導結合プラズマ(ICP)を作り出します。
ICPは15eV未満のイオンエネルギーとなります。
プラズマで生成される酸素ラジカルは炭素と 化学反応してCO, CO2およびH2Oに転化します。
ICPはラスター汚染物質を除去する場合にも非常に効果的です。
ICPでのイオンエネルギーは非常に低いので、有効的な汚染物質が試料の属性を変えることなくコンタミを取り除くことができます。
●プラナリゼーション
イオンビームエッチング(IBE)技術を内蔵し試料表面の均一化が可能です。
イオン源の加速電圧およびビーム電流パラメータは容易に調整でき、 高速での素材除去や試料研磨を段階的に行うことができます。
イオンビームエッチング(IBE)および反応性イオンビームエッチング(RIBE)は エネルギー性イオンを試料表面に照射することで、
粒状組織を露出させたり層と層の間やデバイス構造間の立体的な差異を明らかにし、また試料から異物を除去します。
ASaPは更に反応性イオンエッチング(RIE)システムを搭載しました。
RIEはデバイス構造の選択的な処理を行う半導体業界ではとてもポピュラーなシステムです。
RIEではプロセスガスは電気的にバイアスされた2枚の板の間の空間に導入されます。
反応性プラズマが形成され化学的およびイオンの混合照射効果を通して試料物質は高速かつ選択的に除去されます。
ASaPでは3種類までのプロセスガスを選択したり混合することができます。
CF4およびO2のある特定濃度は多種の半導体材料の前処理に特に効果的です。
●試料コーティング
モデル1030ASaPはイオンアシスト蒸着技術を用いた高解像度コーティングを提供します。
4つのターゲットからアプリケーションに合せて希望するコーティング素材を選択できます。
更に試料に多重コーティングすることも可能です。
蒸着率およびコーティングの厚さは任意にプログラムすることができます。
●グラフィック・ユーザーインターフェイス
モニタースクリーン上のメニューで機器の操作とプログラミングを非常に簡単に行うことができます。
一連のプロセシングシーケンスは試料に合わせて一つずつ調整でき、またあらかじめ設定した方法をメモリーから呼び出すこともできます。
シーケンスが起動すると自動的に全プロセスを実行します。
ユーザーインターフェィスが実行中の操作を継続して各操作のパラメータ状況を表示します。
仕様
| 製品型番 | Model 1040 |
| 本体寸法 | W673mm × D775mm × H1613mm |
| 本体重量 | 194kg |
| イオン源 | 中空陽極放電(HAD) |
| 可変エネルギー | 0.5~6.0kV |
| イオン源電流 | 3~8mA |
| ビーム電流 | Max.400マイクロアンペア |
| 試料ステージ回転 | 1~360°(1度刻みでの設定可能) |
| 設定角度回転 | 0±179° |
| ミリング角度 | 0~45° |
| 制御方法 | パソコン制御 |
| 真空ポンプ | ターボモレキュラーポンプ(70リットル) 除霜装置付ダイヤフラム式ラフィングポンプ採用 |
| プロセスガス | 流速約0.4~1.0sccm/イオン源 10psiの送り圧力 |
| 電源 | AC100V、単相、50/60Hz、7A |





